-
Automatisierung
Das Produktportfolio der PVA SPA Software Entwicklungs GmbH umfasst vollautomatische Systeme für die Qualitätskontrolle von Frontend- und Backend-Halbleiterprodukten. Wir bieten unsere kontinuierlich weiterentwickelten Bildanalyse-Module an, deren Einsatz automatische Sichtinspektionen von Wafers auf 2D-Bildern sowie hochpräzise 3D-Oberflächenprofile ermöglicht. Unser kundenorientierter Ansatz sorgt dafür, dass wir genau die Lösungen bereitstellen, die unsere Kunden benötigen.
Ausrichtungs-/Referenzierungsmodul
- Automatische Wafer-Ausrichtung und -Referenzierung mit Bildverarbeitungslizenz
- Manuelle Wafer-Ausrichtung und -Referenzierung
- Optionale Waferrand- und Flat-/Notch-Profilierung


AOI-Paket für Bump- und Ballinspektionen
- Automatische 3D-Profilierung von Bumps und Balls
- Grenzwertdefinition für obere, mittlere und untere Bump-/Balloberflächenmessung
- Anpassbare Vergrößerung (falls Objektivwechsler vorhanden)
- Ausgabe der Inspektionsergebnisse in Wafermap oder CSV-Ergebnisdatei
- Verwendung von Probeninspektionsalgorithmen möglich
- 3D-Auflösung: 5–50 nm (je nach Material)
- Laterale Auflösung: 0,5–8 µm/px (je nach verwendeter Objektivlinse)
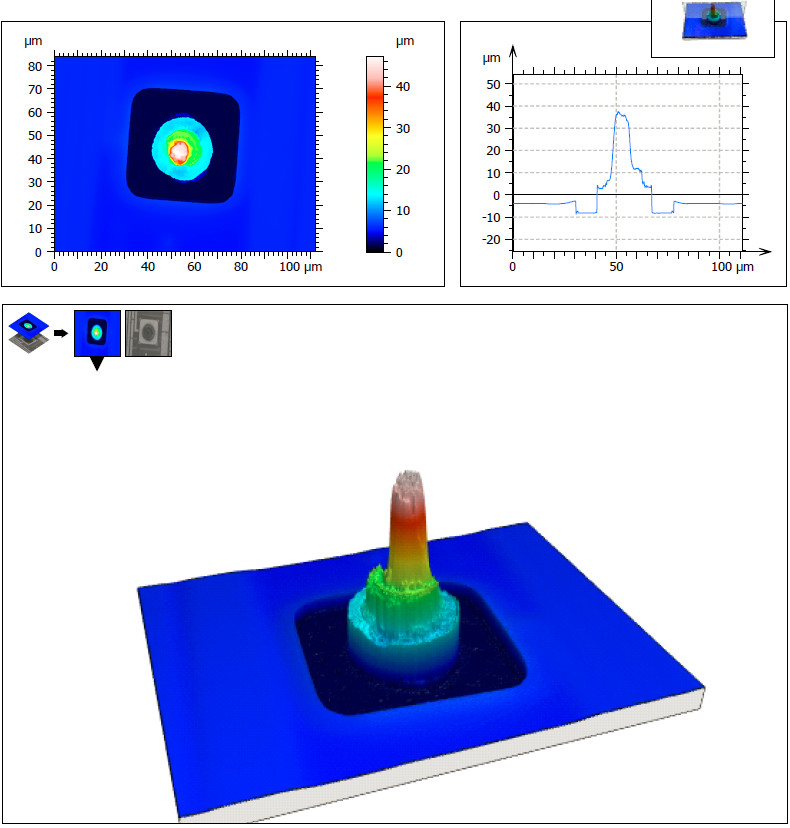
AOI-Paket für Chip-Referenzmodell
- Chip-zu-Chip-Vergleich (feste RM-Schulung pro Wafertyp), Unterstützung für verschiedene Zonen mit unterschiedlichen Gewichten
- Chip-zu-Chip-Vergleich ohne typabhängiges Bildverarbeitungsskript (dynamische RM-Schulung pro Wafer)
- Unterstützt Probenmessung (konfigurierbarer Prozentsatz)
- Programmierung robuster RM-Inspektionsskripts für fünf verschiedene Wafertypen
- Integrierter VSE (Visual Script Editor) für Analysen und Skriptprogrammierung
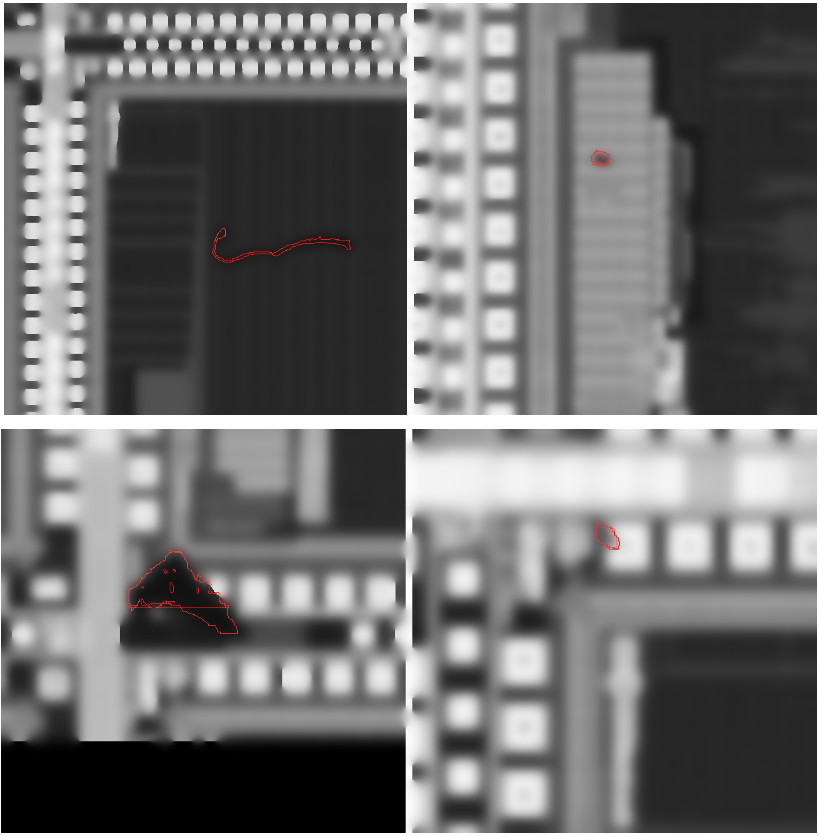
AOI-Paket für Kritische Abmessung (KA)
- Programmierbare Distanzmessungen mit automatischer Kantenerkennung mittels Skriptsprache von PVA SPA
- Produktspezifische Verknüpfung von KA-Programmen in Rezepten
- Verwendung von Probeninspektionsalgorithmen möglich


AOI-Paket für Tintenpunktinspektionsskripte
- Umfassende Qualitätssicherung der Tintenpunkte
- Tintenspritzererkennung auf guten Dies
- Automatisches Nachfärben von Tintenpunktfehlern
- Kontrolle der Tintenpunktgröße (min./max.)
- Kontrolle der Tintenpunktposition
- Kontrolle des Tintenpunktumrisses (Rundheit, Seitenverhältnis)
- Erkennung von Tinte auf Pass-Chip
- Individuelle Inspektionsparameter für Rand-Dies
AOI-Paket für Prüfpunktinspektionen
- 2D-Distanzkontrolle von Scrub zu Pad-Kanten
- Oberflächenkontrolle von Scrub im Pad (in %)
- Optionale 3D-Profilierung von Scrub-Tiefe und -Höhe
- Verwendung von Probeninspektionsalgorithmen möglich
- 3D-Auflösung: 5–50 nm (je nach Material)
Laterale Auflösung: 0,5–8 µm/px (je nach verwendeter Objektivlinse)

AOI-Paket für Sägeinspektionen
- Distanzmessung von Die zu Die an oberer Sägekante
- Distanzmessung von Die zu Die an unterer Sägekante
- Distanzmessung von Sägekante zu Chip-Dichtring
- Messung der Chipgröße an oberer Sägekante
- Messung der Chipgröße an unterer Sägekante
- Vergleich der Chipneigung mit xy-Ausrichtung
- Säglinienprofil in 3D mit Schnittstelle zu MountainsMap-Applikation
- 3D-Auflösung: 5–50 nm (je nach Material)
- Laterale Auflösung: 0,5–8 µm/px (je nach verwendeter Objektivlinse)
-
Manueller Betrieb
Das Produktportfolio der PVA SPA Software Entwicklungs GmbH umfasst manuell betriebene Systeme für die Qualitätskontrolle von Frontend- und Backend-Halbleiterprodukten. Wir bieten unsere kontinuierlich weiterentwickelten Software-Module an, deren Einsatz halbautomatische Workflow-Sequenzen zur Steigerung der Effizienz von Bedienerinspektionen ermöglicht. Unser kundenorientierter Ansatz sorgt dafür, dass wir genau die Lösungen bereitstellen, die unsere Kunden benötigen.
Wafermap-Bearbeitungsmodul
- Chip-Klassifizierung in der Map mittels Tastatur und/oder Maus
- Linienauswahl von Chips mittels mit der Maus gezogenem Rechteck und Polygon für synchrone Klassifizierung
- Sperre der Map, Speicherung des Zwischenergebnisses und Wiederaufnahme der Inspektion zu einem späteren Zeitpunkt möglich

Ausrichtungs-/Referenzierungsmodul
- Manuelle Wafer-Ausrichtung und -Referenzierung
- Gilt für manuelle oder automatische Kreuztische
- Optionale Waferrand- und Flat-/Notch-Profilierung

KLARF-Import-/-Überprüfungs-/-Exportmodul
- Import von KLA Result File (KLARF)
- Defektüberprüfung KLA Result File (KLARF)
- Unterstützt KLARF Version 1.2
- Unterstützt mehrere Defekte pro Chip
- Tabelle/Liste der Defekte in einem Chip
- Tischbewegung zu ausgewählten Defekten
- Unterstützt Fehlerklassen
- Neuklassifizierung von Fehlerklassen
- TIFF-Konvertierung für Defektbilder
- Prozessunterstützung für Bilderfassung (manuell, halbautomatisch, automatisch)
- Automatische Löschung der KLARF und Bilddaten nach n Tagen auf dem Computer
- Automatische Berechnung der Vergrößerung für Defektbilderfassung
- Export von KLA Result File (KLARF) ohne Datenverlust
Paket mit Probeninspektionsalgorithmen
- Voraussetzungen: Konvertierer für Wafermap-Import und motorisierter Kreuztisch
- Chip-Neupositionierung
- Definierte Liste mit Positionen pro Chip und Wafer
- Inspektionsalgorithmus gemäß Chip-Koordinaten (Probe, AQL, LTPD, Rand, 100 %)
- Wechsel zu Chip mittels Mausklick auf Mapanzeige mit anpassbarem relativen Chip-Offset

Inspektionsberichte
- Kundenspezifische Chargenberichte (.txt, .csv, .xml)
- Bericht des KLA Result File
Kundenspezifische Inspektion zur Qualitätssicherung
- Stepping und Neuklassifizierung von Bincode-Defektüberprüfungen
- Individuelle Wafer- und Chip-Probennahmeroutinen für Vorder- und Rückseite von geschnittenen gerahmten Wafers
- Projektspezifische Entwicklungen